英特尔研究团队近日公布了一项针对先进封装芯片的新型散热技术方案,旨在解决高功率芯片在大规模集成过程中面临的散热与制造成本难题。相关研究成果已通过论文形式发布,展示了其在提升封装效率和热管理性能方面的显著进展。
该方案被称为“集成散热器分解式设计”,核心思路是将传统一体化的集成散热结构拆分为多个几何形状简单、易于生产的独立组件,并通过标准工艺流程完成组装。这种模块化方式不仅降低了加工复杂度,还大幅提升了制造的经济性与工艺适配性。
新设计在实际应用中展现出多重优势。对于多层堆叠及多芯片异构集成的先进封装结构,该方案可有效减少约30%的封装翘曲,同时将热界面材料中的空洞率降低25%,从而增强热传导效率,提升整体可靠性。此外,封装共面性亦改善约7%,使芯片表面更加平整,有利于后续封装工艺的稳定执行。
随着现代芯片尺寸不断突破7000mm²的技术边界,传统集成散热器因需精密加工阶梯式腔体和多接触界面,导致制造难度激增、成本迅速上升。而此次提出的分解式架构,成功规避了此类加工瓶颈,为开发超大尺寸先进封装产品提供了可行路径。
通过优化粘合剂分布、平板结构以及加固元件布局,该方案进一步强化了热界面材料的工作性能,确保在高热负载条件下仍能维持稳定的散热能力。这一突破有望支撑未来更大规模、更高密度芯片系统的研发与量产,成为推动高性能计算平台持续演进的关键技术基础。



























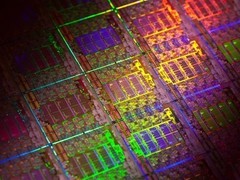








































评论
更多评论