台积电近日在北美技术研讨会上宣布,公司正在研发CoWoS封装技术的下个版本。这款技术可以让系统级封装(SiP)尺寸增大两倍以上,实现120x120mm的超大封装,并且功耗可以达到千瓦级别。
根据官方描述,CoWoS封装技术的继任者所创建的硅中介层,其尺寸是光掩模(Photomask,也称Reticle,大约为858平方毫米)是3.3倍。这种技术可以将逻辑电路、8个HBM3/ HBM3E内存堆栈、I/O和其他芯粒(Chiplets)封装在一起,最高可以达到2831平方毫米,最大基板尺寸为80×80毫米。
据悉,AMD的Instinct MI300X和Nvidia的B200都使用了这种技术。
台积电计划于2026年投产下一代CoWoS_L封装技术。该技术的硅中介层尺寸可以达到光掩模的5.5倍。它可以将逻辑电路、12个HBM3/ HBM3E内存堆栈、I/O和其他芯粒(Chiplets)封装在一起,最高可以达到4719平方毫米。
此外,台积电还计划在2027年继续推进CoWoS封装技术,使硅中介层尺寸达到光掩模的8倍以上。这将提供6864平方毫米的空间,可以封装4个堆叠式集成系统芯片 (SoIC),并与12个HBM4内存堆栈和额外的I/O芯片一起使用。


















































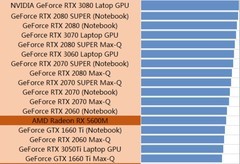




















评论
更多评论